龙8头号玩家晶圆承载系统是指针对晶圆背面减薄进行进一步加工的系统,该工艺一般在背面研磨前使用。晶圆承载系统工序涉及两个步骤:首先是载片键合,需将被用于硅通孔封装的晶圆贴附于载片上;其次是载片脱粘,即在如晶圆背面凸点制作等流程完工后,将载片分离。
图7展示了晶圆承载系统的工艺步骤。首先在晶圆表面涂覆临时粘合剂,使其贴附于载片上;待晶圆背面的加工工序完成后,即可对载片进行脱粘,并去除残留粘合剂,以确保晶圆表面清洁。
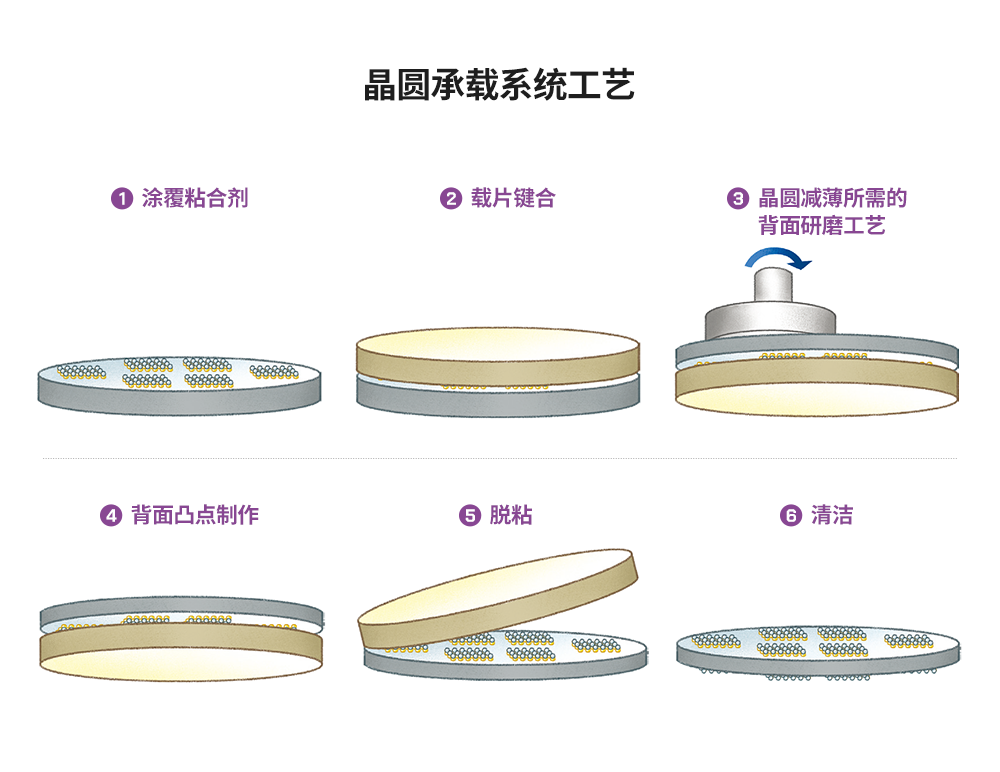
进行载片键合时,需要注意几个因素:首先,载片键合后的晶圆整体厚度应均匀一致;其次,键合面不应存在空隙,两片晶圆对齐应准确无误;此外还应确保晶圆边缘不受到粘合剂污染,且在处理过程中应尽量避免晶圆发生弯曲。在载片脱粘过程中,还应注意:避免晶圆脱离载片后发生损坏,如边缘剥落(Chipping)7或出现裂纹等;避免粘合剂残留;避免凸点变形。
在基于晶圆承载系统的封装工艺中,载片脱粘是一个相对复杂且重要的工序。因此,业界已经提出并研发多种脱粘方法,并针对每一种脱粘方法开发出相应的临时粘合剂。典型的脱粘方法包括热技术、激光烧蚀(Laser Ablation)后剥离、化学溶解、机器剥离后化学清洗等。
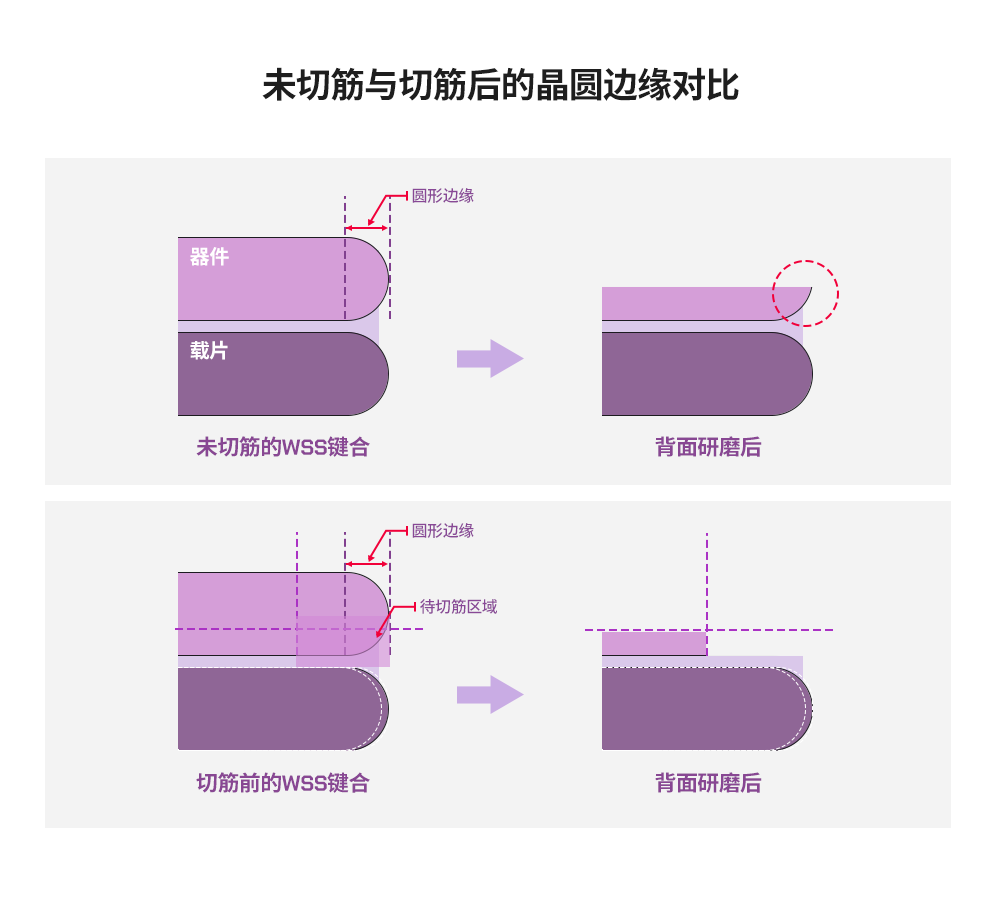
如图8上半部分红圈内区域所示,将采用硅通孔工艺封装的晶圆键合到晶圆载片上,经过背面研磨后,其边缘会变得较为尖锐。此种状态下,晶圆后续还将经历光刻、金属薄膜制备、电镀以在背面制作凸点等工序龙8头号玩家,这些工序会增加晶圆边缘剥落的风险。边缘裂纹可能会延伸至晶圆内部,进而导致后续工序无法进行,最终造成严重的良品损失。为避免此问题,对于采用硅通孔工艺封装的晶圆,在其进行载片键合前,应先对晶圆正面边缘进行切筋并去除修剪部分。如图8下半部分区域所示,将切筋后的晶圆贴附于晶圆载片并对其进行背面研磨时,锋利而凸起的边缘已消失。因此,在后续工序中,晶圆边缘剥落的风险也被消除。在切筋过程中,旋转的晶圆切割刀片穿过晶圆边缘,将指定的边缘区域切除。
硅通孔封装工艺中,在晶圆正面和背面形成的凸点均用于键合,以便堆叠。同样地,在倒片键合时,批量回流焊(Mass Reflow)工艺8和热压缩(Thermocompression)工艺9也用于键
8批量回流焊工艺(Mass Reflow):将多个器件按陈列连接到基板上,然后在烤箱等中一起加热,以熔化焊料使之形成互联的工艺。因一次性处理多个器件,所以在这个术语中使用了“批量”这一词。
9热压缩工艺(Thermocompression):对物体进行加热和加压处理,使其进行键合的一种工艺。
使用硅通孔工艺堆叠芯片时,需使用微型凸点。因此,凸点之间的间距很小,堆叠芯片之间的间距也很小,这就是以可靠性著称的热压缩工艺因被广泛使用的原因。然而,热压缩工艺也存在缺点,那就是耗时长,生产率底,因为在键合过程中必然会耗时去加热加压。因此热压缩工艺逐渐被批量回流焊工艺取代的趋势日益明显。
(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有
,元器件供应商正寻求在更多应用中使用WLP,而支持WLP的技术也正快速走向成熟。随着元件供应商正积极转向
下料磨边→钻孔→沉铜加厚→外层图形→镀镍、金去膜蚀刻→二次钻孔→检验→丝印阻焊→丝印字符→外形加工→测试→检验。4.
CSP时,将其当做倒装晶片并采用助焊剂浸蘸的方法进行组装,以取代传统的焊膏印刷组装龙8头号玩家,如图2所示,首先将
图 /
现在用交流通过整流滤波稳压之后的电压(正负电压),直接给运放进行供电,实现不了。在PSPICE中仿线 阅读

